化学机械抛光技术
为满足芯片微型化、高密度化、高速化、高数字化和系统集成化的要求,对芯片直径、平坦化、线宽和金属互连层数提出了更高要求,这也对晶片的精密加工提出了更高要求。
半导体晶圆(芯片)加工工艺流程如图1所示。

由于大规模集成电路(ULSI)向高度集成和多层布线发展,化学机械抛光、平坦化已成为集成电路制造不可缺少的关键工艺。它不仅是硅晶圆加工中终获得纳米光滑、无损伤表面的有效方法,也是芯片多层布线中不可替代的层间局域平坦化方法。在晶圆(芯片)制造过程中(见图1)多次使用CMP工艺。
化学机械抛光过程(见图2)使用安装在刚性抛光平盘上的柔性抛光垫,硅片被压在抛光垫上,在抛光液的作用下进行抛光,抛光液含有化学液(即双氧水H2O2)和纳米磨料。硬的硅基陶瓷材料由磨料的机械作用抛光,而金属则由金属和抛光液内的化学物质之间的化学反应进行抛光,即采用化学与机械方法综合作用去除多余材料而得到平坦化的高质量表面。
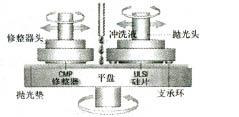
转载需附出处及原文链接 http://www.jzdz-wx.com/
无锡吉致电子科技有限公司
咨询热线:17706168670
相关资讯
最新产品
同类文章排行
- 吉致电子碳化硅SiC抛光液的作用
- 半导体衬底抛光工艺---磷化铟InP抛光液
- 吉致电子--单晶金刚石研磨液的用途
- 生物芯片抛光---吉致碳酸钙抛光液
- 吉致电子--磨具抛光液 配油盘加工抛光
- 吉致电子 Diamond slurry多晶金刚石研磨液
- 吉致电子---常见的半导体研磨液有哪些
- 第三代半导体材料--碳化硅晶圆SiC抛光液
- 吉致电子手机取卡针抛光液
- CMP抛光液---纳米氧化铈抛光液的优点
最新资讯文章
您的浏览历史







